Màquina de soldadura BGA òptica manual
Màquina de soldadura bga òptica manual 1. Vista prèvia ràpida: l'estació de soldadura BGA DH-G600 s'utilitza àmpliament a la reparació de nivell de xip en portàtils, PS3, PS4, XBOX360, telèfon mòbil, etc. Equipat amb funció de posicionament làser, estació de reelaboració bga DH-G600 es pot col·locar ràpidament al xip BGA i a la placa base. 2....
Descripció
Màquina de soldadura òptica manual bga
1. Vista prèvia ràpida:
L'estació de soldadura BGA DH-G600 s'utilitza àmpliament en la reparació del nivell de xip en portàtils, PS3, PS4, XBOX360, telèfon mòbil, etc.
Equipat amb la funció de posicionament làser, l'estació de retreball bga DH-G600 es pot col·locar ràpidament al xip BGA i a la placa base.
|
Paràmetre del producte |
|
|
Nom del producte |
màquina de soldar i desoldar |
|
Potència total |
5300W |
|
calefacció superior |
1200w |
|
calefacció inferior |
Escalfament d'aire calent inferior 1200W, preescalfament IR 2700W |
|
Poder |
220V 50HZ/60HZ |
|
Posicionament |
Les plaques de PCB de ranura en V es poden ajustar en els eixos X, Y i equipar-se amb un accessori universal |
|
Control de temperatura |
Tipus K, bucle tancat |
|
Mida del PCB |
Màxim 400x380 mm, mínim 22x22 mm |
|
Mida del xip |
2x2-50x50 mm |
|
Espaiat mínim entre xips |
0,15 mm |
|
Sensor de temperatura extern |
1 (opcional) |
|
N.W. |
uns 60 kg |
|
Plaques base adequades |
telèfon mòbil, portàtil, escriptori, consola de jocs, XBOX360, PS3 |
2. Descripció del producte de l'estació de retreball BGA DH-G600
Característiques:
1. L'últim nou sistema d'alineació òptica, fàcil d'operar, la taxa d'èxit pot ser del 100%.
2. Amb posició làser.
3. Identificació automàtica de xips BGA i alçada de muntatge.
4. Dispositiu de calefacció superior i capçal de muntatge disseny 2 en 1.
5. Soldadura i desoldació semiatòmica.
6. El sistema CCD i el sistema d'alineació òptica combinats, poden canviar la pantalla amb un botó.
7. Ajust automàtic de la resolució del cromatisme i la brillantor.
8. Amb posició làser.
9. Amb Micròmetre per fer Micro ajustar.
10. Amb un potent ventilador de flux creuat per refredar la PCB ràpidament per evitar que es deformi.
11. Amb 3 zones de temperatura i un endoll de sensor de temperatura opcional.
3. Passos de reparació:
Separeu el xip BGA de la placa base -hem anomenat desoldar
Coixinet net
Reballar o substituir un xip BGA nou directament
Alineació/posicionament: depèn de l'experiència, marc de seda, càmera òptica
Substituïu un xip BGA nou: hem anomenat soldadura
4.Imatges detallades de G600 BGA REWORK STATION
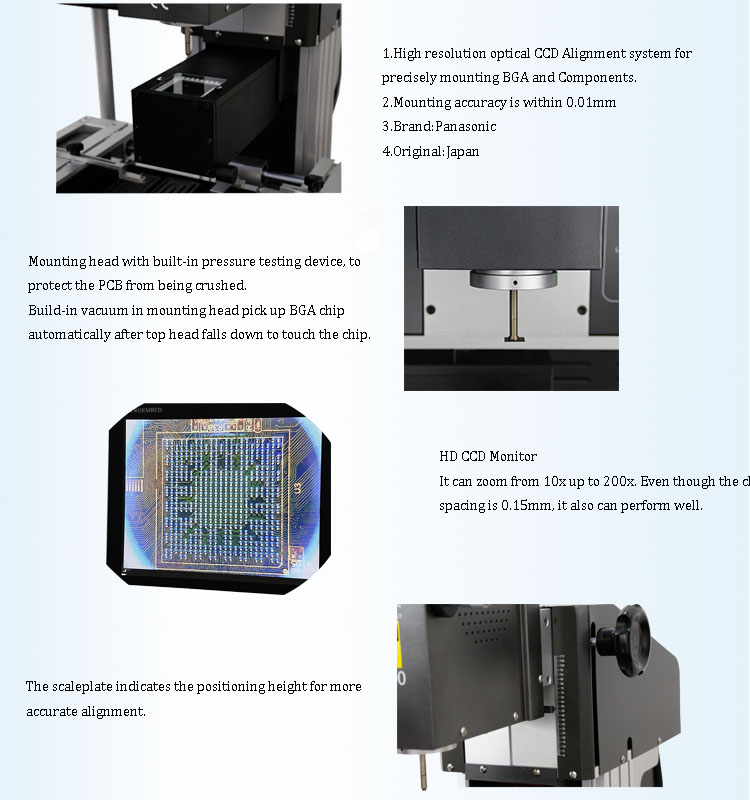
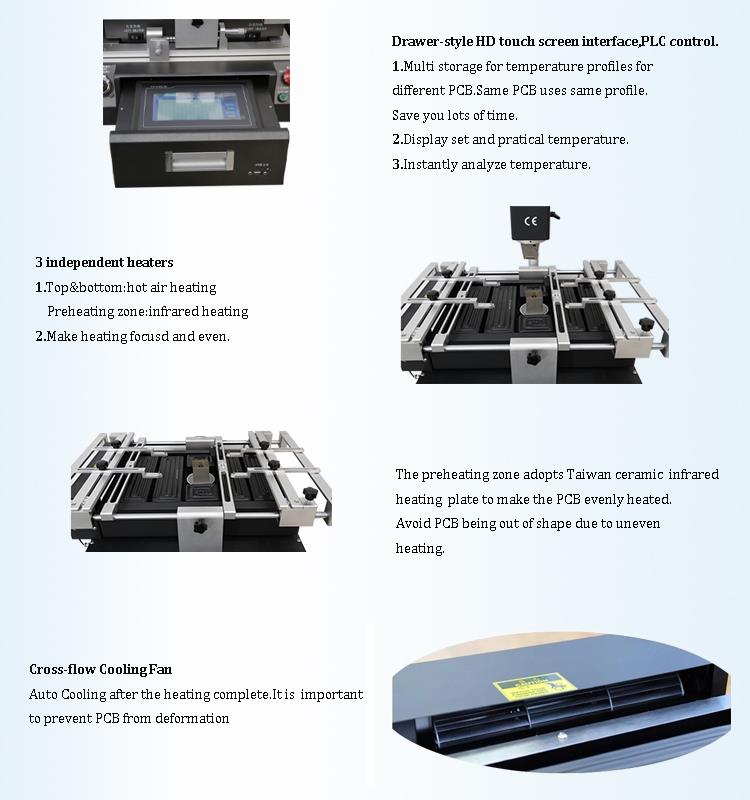

5.Perfil de l'empresa
Algunes imatges de la nostra fàbrica i l'estació de retreball BGA
Oficines

Mlínies de fabricació

Certificació CE com a continuació

Part dels nostres clients

6. Embalatge i lliurament i serveis de G600 BGA REWORK STATION


7.Coneixements relacionats
Quatre mètodes de plantació de boles
En general, hi ha quatre mètodes per aplicar l'empalmament de boles BGA, és a dir, el mètode d'utilitzar només el dispositiu, el mètode d'utilitzar la plantilla, la col·locació manual i el raspallat de la quantitat adequada de pasta de soldadura.
Si hi ha una pinça de bola que selecciona una plantilla que coincideixi amb el coixinet BGA, la mida d'obertura de la plantilla hauria de ser 0.05--0, 1 mm més gran que el diàmetre de la bola de soldadura. Esteneu la bola de soldadura uniformement a la plantilla, agiteu el dispositiu de rodament de boles i poseu l'excés de soldadura. La bola s'enrotlla des de la plantilla fins a la ranura de recollida de boles de soldadura del sembrador de boles de manera que
només es conserva una bola de soldadura a cada forat de fuita de la superfície de la plantilla
Col·loqueu el flux de soldadura imprès o el dispositiu BGA de pasta al banc de treball amb el flux o la pasta de soldadura cap amunt. Prepareu una plantilla de coincidència de coixinets BGA. L'obertura de la plantilla ha de ser 0.05-0.1 mm més gran que el diàmetre de la bola de soldadura. Col·loqueu la plantilla al voltant del coixinet i col·loqueu-la sobre el component BGA imprès del flux o pasta de soldadura. La distància entre els BGA és igual o lleugerament menor que el diàmetre de les boles de soldadura, alineades sota el microscopi. Esteneu la bola de soldadura de manera uniforme a la plantilla i utilitzeu les pinces per eliminar l'excés de bola de soldadura de manera que només quedi una bola de soldadura a cada forat de fuita a la superfície de la plantilla. Traieu la plantilla, comproveu-la i completeu-la.
Col·loqueu el flux de soldadura imprès o el dispositiu BGA de pasta al banc de treball amb el flux o la pasta de soldadura cap amunt. Col·loqueu les boles de soldadura una per una amb una pinça o un llapis com un pegat.
8.4 Raspall la quantitat adequada del mètode de pasta de soldadura
Quan es processa la plantilla, el gruix de la plantilla s'engrossi i la mida de l'obertura de la plantilla s'amplia lleugerament i la pasta de soldadura s'imprimeix directament al coixinet de la BGA. A causa de la tensió superficial, les boles de soldadura es formen després del reflux. En aquest article s'utilitza el mètode de plantació de boles. A continuació es descriu el mètode de plantació de boles de la sembradora de boles.