
Estació de retreball BGA SP360c PS3 PS4
1. Reparació eficaç de plaques base de PS3, PS4, SP360C, mòbil, portàtil.2. El ventilador de refrigeració de flux creuat garanteix la funció de refrigeració automàtica, que garanteix una llarga vida útil i evita danys.3. El posicionament làser d'infrarojos ajuda a posicionar la placa base de manera fàcil i ràpida.4. Pantalla tàctil d'alta definició.
Descripció
1.Aplicació de l'estació automàtica de retreball BGA per a SP360c PS3 PS4
Treballa amb tot tipus de plaques base o PCBA.
Soldar, reballar, desoldar diferents tipus de xips: BGA, PGA, POP, BQFP, QFN, SOT223, PLCC, TQFP, TDFN, TSOP, PBGA, CPGA, xip LED.

2. Característiques del producte de l'estació automàtica de retreball BGA per a SP360c PS3 PS4

3.Especificació de l'estació de retreball BGA automàtica per a SP360c PS3 PS4
| Poder | 5300W |
| Escalfador superior | Aire calent 1200W |
| Escalfador Bollom | Aire calent 1200W, infrarojos 2700W |
| Font d'alimentació | AC220V±10% 50/60Hz |
| Dimensió | L530 * W670 * H790 mm |
| Posicionament | Suport de PCB de ranura en V i amb fixació universal externa |
| Control de temperatura | Termopar tipus K. control de llaç tancat. calefacció independent |
| Precisió de temperatura | ±2 graus |
| Mida del PCB | Màxim 450*490 mm, mínim 22*22 mm |
| Ajustament del banc de treball | ±15 mm endavant/enrere, ±15 mm dreta/esquerra |
| BGAchip | 80*80-1*1 mm |
| Espaiat mínim entre xips | 0,15 mm |
| Sensor de temperatura | 1 (opcional) |
| Pes net | 70 kg |
4.Detalls de l'estació automàtica de retreball BGA per a SP360c PS3 PS4
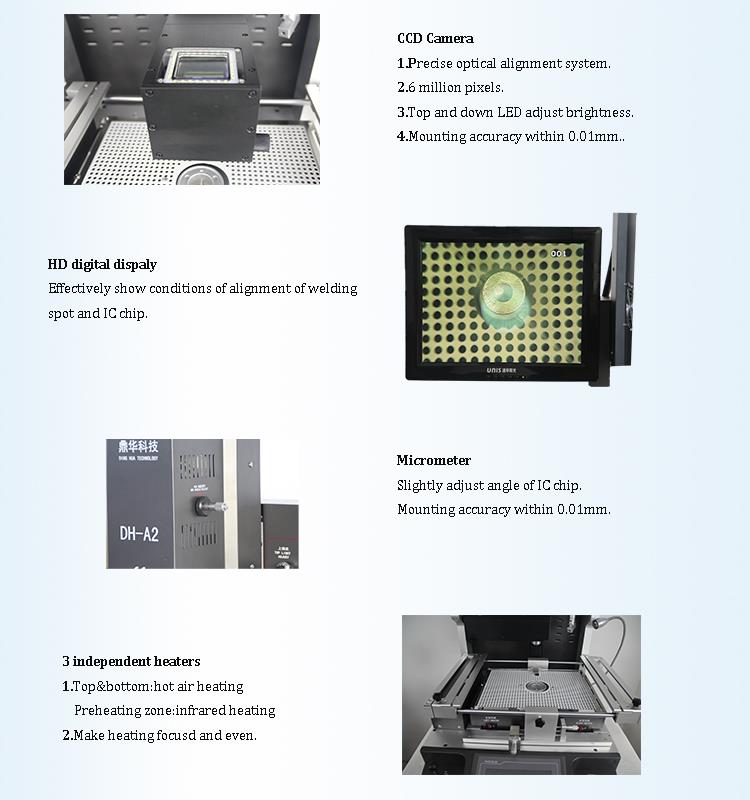

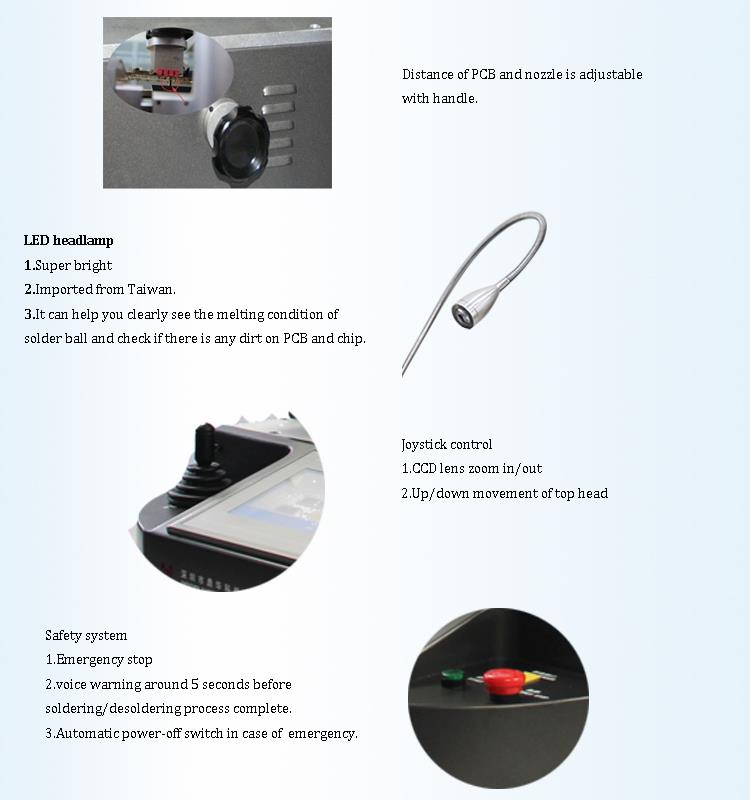
5.Per què triar la nostra estació automàtica de retreball BGA per a SP360c PS3 PS4?


6.Certificat d'estació de retreball BGA automàtica per a SP360c PS3 PS4
Certificats UL, E-MARK, CCC, FCC, CE ROHS. Mentrestant, per millorar i perfeccionar el sistema de qualitat, Dinghua ha aprovat la certificació d'auditoria in situ ISO, GMP, FCCA, C-TPAT.

7. Embalatge i enviament de l'estació automàtica de retreball BGA per a SP360c PS3 PS4

8.Enviament perEstació automàtica de retreball BGA per a SP360c PS3 PS4
DHL/TNT/FEDEX. Si voleu un altre termini d'enviament, digueu-nos-ho. Us donarem suport.
9. Condicions de pagament
Transferència bancària, Western Union, targeta de crèdit.
Si us plau, digueu-nos si necessiteu un altre suport.
11. Coneixements relacionats
Tractament de bombolles durant el retreball
En conjunts amb components de terminació inferior (BTC), la presència de bombolles d'aire ha estat un problema greu per a moltes aplicacions. Per definir les bombolles, la següent és una descripció dels defectes de soldadura:
[...] L'estany es fon ràpidament per omplir els buits adequats i captura una mica de flux a les juntes de soldadura. Aquestes bombolles de flux atrapades són buides; [...] Aquests buits impedeixen que la llauna ompli completament la junta. En aquestes juntes de soldadura, la soldadura no pot omplir tota la junta perquè el flux s'ha segellat a l'interior. [1]
En el camp SMT, les bombolles poden provocar els efectes següents: [...] Com que hi ha una quantitat limitada de soldadura que es pot aplicar a cada unió, la fiabilitat de les unions de soldadura és una preocupació principal. La presència de bombolles ha estat un inconvenient comú associat a les juntes de soldadura, especialment durant la soldadura per reflux en SMT. Les bombolles poden debilitar la força de la junta de soldadura i, en última instància, condueixen a una fallada de la junta de soldadura. [2]
L'impacte en la qualitat de la junta de soldadura a causa de la formació de bombolles s'ha discutit moltes vegades en diversos fòrums:
- Reducció de la transferència de calor del component al PCB, augmentant el risc de temperatura corporal excessiva del component.
- Reducció de la resistència mecànica de les juntes de soldadura.
- El gas s'escapa de la junta de soldadura, que pot provocar esquitxades de soldadura.
- Capacitat de corrent reduïda de la junta de soldadura (capacitat d'amperatge): la temperatura de la unió augmenta a causa de l'augment de la resistència a la junta de soldadura.
- Problemes de transmissió del senyal: en aplicacions d'alta freqüència, les bombolles poden debilitar el senyal.
Aquest problema és especialment important en l'electrònica de potència, on la formació de bombolles als coixinets tèrmics (com els components del paquet QFN) s'està convertint en una preocupació creixent. La calor s'ha de transferir des del component al PCB per a la seva dissipació. Quan aquest procés crític es veu compromès, la vida útil del component es redueix significativament.
Mètodes convencionals per reduir les bombolles:
Alguns mètodes convencionals per reduir les bombolles inclouen l'ús de pasta de soldadura de bombolles baixes, l'optimització del perfil de reflux i l'ajust de les obertures de la plantilla per aplicar la quantitat òptima de pasta de soldadura. A més, abordar la formació de bombolles quan la pasta de soldadura està en estat líquid és un altre aspecte important de la solució durant tot el procés de muntatge electrònic.
Així doncs, sorgeix la pregunta: com es pot aplicar el procés de tractament de bombolles en un entorn obert com els equips de retreball? La tecnologia de buit utilitzada en la soldadura per reflux és clarament inadequada. Una tècnica basada en l'excitació sinusoïdal del substrat de PCB és més adequada per a la reelaboració (figura 1). En primer lloc, el PCB és excitat per una ona longitudinal amb una amplitud inferior a 10 μm. Aquesta ona sinusoïdal excita el PCB a una freqüència específica. En aquesta regió, tant el cos del PCB com les juntes de soldadura del PCB ressonen sota estrès. Quan el PCB està exposat a l'energia, els components romanen al seu lloc i les bombolles es forcen a les regions de la vora de la soldadura líquida, cosa que els permet escapar de les juntes de soldadura.
Mitjançant aquest mètode, la proporció de bombolles es pot reduir al 2% en la soldadura de nous components (Fig. 2). Fins i tot amb aquesta tècnica, es pot aconseguir una eliminació significativa de bombolles a les juntes de soldadura objectiu del PCB muntat durant el procés de refluig secundari. En aquest procés de reelaboració de bombolles, només l'àrea seleccionada del PCB s'escalfa a temperatures de refluig, i només aquesta àrea s'excita de manera sinusoïdal, de manera que no hi ha cap impacte negatiu en tot el producte.
Onades d'escaneiges propaguen longitudinalment al llarg del substrat de PCB.
L'excitació es realitza mitjançant una ona d'exploració lineal produïda per un actuador piezoelèctric.
- Manipulació de bombolles en PCBA amb un controlador piezoeléctric.
- Activació de la funció d'excitació durant el reflux per reduir significativament la proporció de bombolles a la MLF (abans i després de l'aplicació).







